文 观察者网心智观察所
仲春时节,惊蛰待发,半导体行业响起了一声“春雷”。
据韩国媒体报道称,三星电子近日与中国存储芯片厂商长江存储签署了专利许可协议,将从后者获得3D NAND“混合键合”专利。
从全球存储行业的竞争格局来看,长江存储作为中国半导体以及存储赛道龙头企业,相比海外三大家三星、海力士、美光等依然只能算后起之秀。
这一次长江存储对三星的3D NAND“混合键合”专利授权,恰如同新生的藤蔓攀上苍劲的古松,以更鲜活的姿态逐渐触摸到先进封装那颗皇冠上的明珠。
当三维集成电路的层峦叠嶂成为存储世界的通天塔,后来者执光刻之刃劈开技术壁垒的坚冰。在三星与美光构筑的128层晶体圣殿之巅,中国军团以Xtacking架构为密钥,将存储单元与逻辑电路的量子纠缠演绎成微观世界的协奏曲,在先进工艺节点中重构存储密度的星辰大海。
混合键合,先进封装绝对的战略高地
这一次长江存储和三星的合作,这个关键词——混合键合(Hybrid Bonding),将其称之为先进封装的绝对战略高地也毫不为过。
混合键合主要有两种使用方式。第一种是晶圆到晶圆(wafer to wafer),主要用于用于CIS 和NAND。铜混合键合最早出现在2016年,当时索尼将这项技术用于CMOS图像传感器;另一种是裸片到晶圆混合键合(die to wafer),这比晶圆间键合更加困难,但这种工艺变化对于逻辑和高带宽存储HBM很有意义。
这一次的技术授权,主要就是晶圆到晶圆(wafer to wafer)的3D NAND。
混合键合为何一定要完成从可能性到现实性的跨越?
传统倒装焊(Flip Chip)受限于焊球尺寸(微米级)和间距,I/O密度提升遭遇物理天花板。混合键合可以通过铜-铜直接键合与介电层融合,将互连间距压缩至亚微米级(甚至突破1μm),单位面积互连密度提升10倍以上。这种“分子级焊接”使Chiplet间信号传输路径缩短至微米量级,彻底改写多芯片模块的性能边界。
混合键合相比传统凸块,极大地增强了单位面积互连密度
打个比方,这就如同将城市间高速公路升级为纳米尺度的神经元突触网络。
2.5D或者3D先进封装往往需要TSV打孔来打通,来连接存储层和逻辑层,再加上封装基板和中介层(或者重新布线层RDL)产生的各种应力、散热问题,让封装的整体可靠性打了不少折扣。
在在AI算力需求爆炸性增长背景下,业界在思考这样一个可能性方向:如何能进一步提升芯片间互连能效比,减少了层间物理连接,使芯片设计更紧凑,并且有利于实现更高性能和传输密度?
换言之,能否将逻辑芯片与存储单元的3D堆叠从“楼层式公寓”升级为“细胞级共生”?
混合键合技术应运而生,应势而起。
想象在纳米尺度的曼哈顿,HBM芯片犹如一座由记忆晶体筑成的垂直都市。传统TSV工艺如同在楼板间浇筑钢筋骨架,虽能支撑起128层的记忆帝国,却让芯片厚度化作束缚天际线的沉重枷锁。
而当混合键合技术这道量子胶体渗入建筑师的蓝图,微观世界的建造法则就此颠覆——如同将钢构大厦转化为自生长的水晶丛林,每层存储器不再需要笨重的金属立柱,仅凭原子级的电磁亲和力便能实现层间量子隧穿。
这项封装魔法将芯片剖面削薄至光子跃迁的尺度,让存储巨塔在保持云端高度的同时,底座却轻盈如蝉翼。这已超越物理键合的维度,实则是让电子在三维迷宫中跳起贴合华尔兹的微雕艺术。
还有一点,若要实现芯片的“制程民主化”,混合键合技术几乎是一条必由之路。当制程进入3nm后,单颗大芯片的良率悬崖与光罩成本飙升形成双重绞杀。混合键合支持将超大芯片解构为多个成熟制程芯粒,通过异构集成实现等效系统性能。这种“乐高式拼装”不仅规避了先进制程的高昂成本,更开创了“制程民主化”新时代——模拟、射频、存储等模块可灵活选择最优工艺节点。
长江存储的技术储备
这一次技术专利授权,涉及到长江存储的前瞻性布局。
多年以来,业界广泛关注长江存储在3D NAND的层数上,并且把这个层数作为一种赶超指标直接对标海外大厂,比如说该厂在2022年量产128层3D NAND,并快速推进232层产品研发,这一标志性节点意味着长江存储堆叠技术达到国际第一梯队水平。
以此为背景,长江存储的Xtacking 3.0 混合键合技术储备其实更值得挖掘——这个全球首创的Xtacking技术,将存储单元与外露电路分离制造,引入铜-铜直接键合,这种“双晶圆异构集成”模式突破了传统NAND架构的物理限制,在I/O速度、晶圆面积利用率、缩短研发周期方面取得了重大突破。
更值得一提的是,长江存储在专利布局方面是个“老手”,这也是迫使三星附身就范的关键。该厂的多层堆栈刻蚀解决了高层数堆叠中的孔洞均匀性难题,与混合键合技术一起构成了很深的专利护城河。截至2023年,全球公开专利申请超8000件,其中3D NAND相关专利占比超60%,并且开辟了标准制定第二战线,加入JEDEC、ONFI等国际标准组织,推动Xtacking接口协议成为行业可选方案。
在与西部数据、铠侠等建立专利池,降低国际化市场准入风险的同时,长江存储关键专利已经让三星、美光无法绕开,一个经典案例是2023年起诉美光侵犯其3D NAND结构专利,实现了反向制约国际巨头。
求救长江存储,三星着急了
无论从技术布局时间和市场触角的深度,三星在混合键合方面目前都不算业界最领先的。竞争对手SK海力士2024年吃饱了HBM红利,甩开了三星一个身位,让三星存储和代工部门颇感压力。
追溯过往,在晶体管诞生75周年的2022年IEDM会议上,英特尔就展示了其采用混合键合技术,计划将这一技术应用于其3D封装技术Foveros Direct,虽然后面商业化落地障碍重重,但其先声得到了SK海力士的实质性回应。
SK海力士预计将在2025至2026年间实现其混合键合技术的商业化。韩国媒体消息指出,SK海力士近期与台积电共同发起了名为“One Team Strategy”的联盟,两家将共同研发第六代HBM芯片。
SK海力士和三星不但在争夺市场,还在争夺设备商的产能。
荷兰设备商Besi、奥地利的EV Group等目前在晶圆混合键合领域处在领先地位,并且和英特尔、台积电已经建立了广泛的合作。
2023年,Besi曾表示它已经有能力每年生产180台混合键合机——抢夺混合键合机,就如同前道设备抢夺光刻机一样,是一个单位时间内存量市场的搏杀。
因此,三星电子与中国存储芯片厂商长江存储签署的这份专利许可协议有其紧迫性和必要性。
结语 混合键合,未竟的伟业
全球能熟练掌握2.5D/3D封装的企业少之又少,靠传统的通过硅通孔(TSV)+填充物的连接方式本就已经很难,混合键合则又是难上加难。
笔者在调研苏州某家键合设备企业时,该企业总经理指出,混合键合不仅延续了传统键合的“汤汤水水”问题,对设备的精确度稳定性,以及器件材料都有极高的要求:“混合键合还涉及到多步骤工艺协同,如清洗、活化、对准、键合、退火等多环节,任一环节波动均影响良率。薄化晶圆或多层堆叠时,应力累积可能导致翘曲,需优化支撑结构或引入应力缓冲层,很多领域在工程学上还处在探索阶段。”
在混合键合的技术专利储备方面,长江存储已经建立了一条护城河。
在纳米尺度构筑专利长城,混合键合的每一根铜柱都在原子森林中拔地而起,化作集成电路世界的马奇诺防线。那些用电子束雕刻的专利边界,不是冰冷的法律条文,而是将工艺秘方熔铸成青铜法典的文明图腾——当国际巨头试图用专利火把照亮技术荒原时,国产厂商的混合键合专利矩阵早已在晶圆上生长出带刺的量子玫瑰,每片花瓣都是能反向穿透侵权壁垒的拓扑绝缘体。
这护城河里流淌的不是水银,而是用自对准通孔编织的纳米级蒺藜,在看似平静的键合界面下埋藏着千万个专利地雷。那些被电子显微镜检视过的键合角度、热膨胀系数与界面钝化配方,正以专利族形式在PCT条约疆域上投射出六边形防御蜂巢。即便摩尔定律的洪水漫过物理堤坝,这座用专利铆钉加固的城邦,仍能在半导体版图上撑起一片技术治外法权的孤岛。
未雨绸缪者从不在暴雨降临时才锻造盾牌,他们在光刻机的紫光中预见了十年后的法律硝烟。此刻每项混合键合专利的授权,都是向未来战场空投的智能军械——当国际专利战的沙尘暴掠过EDA工具构建的虚拟战场,这些提前注册的工艺坐标,将成为穿透对方专利领空的洲际坐标。毕竟在硅基文明的进化史上,真正的技术主权永远镌刻在专利地堡最深处的不锈钢掩体里。
来源|心智观察所


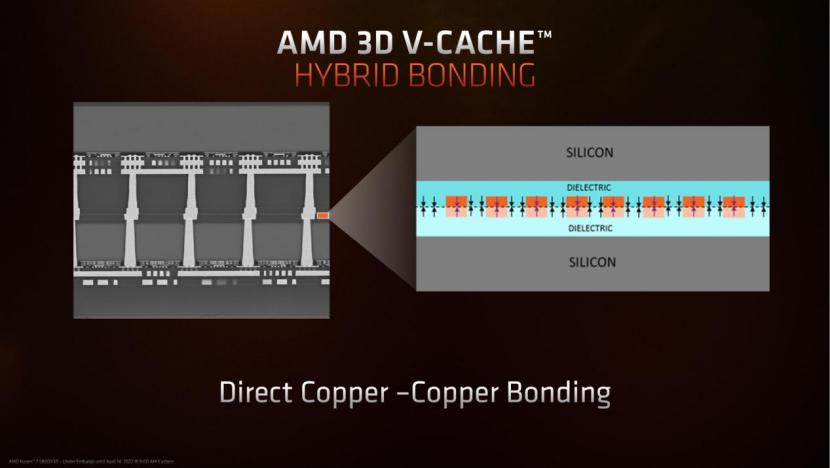

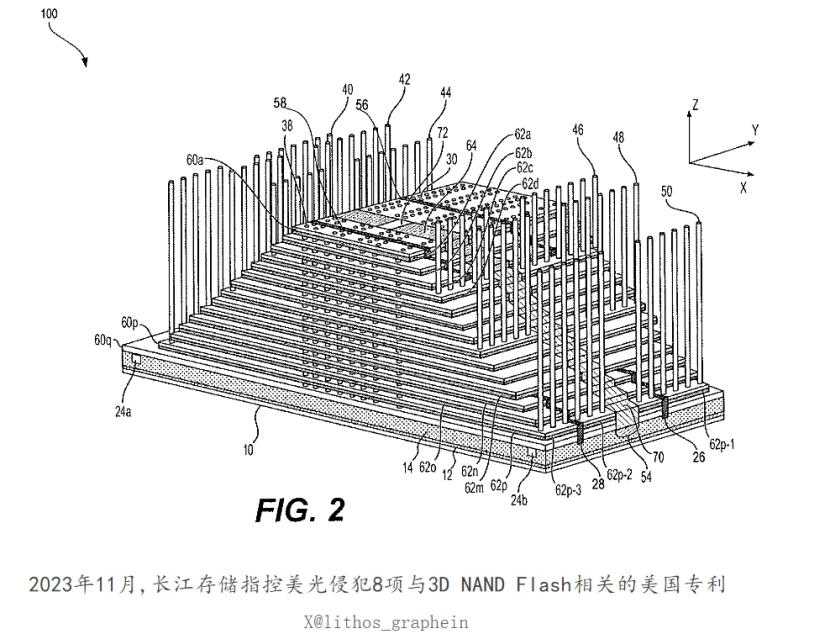
还没有评论,来说两句吧...